





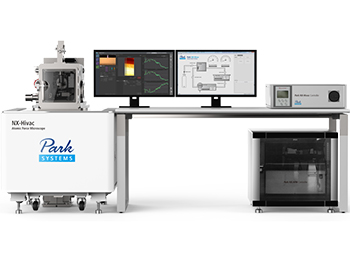



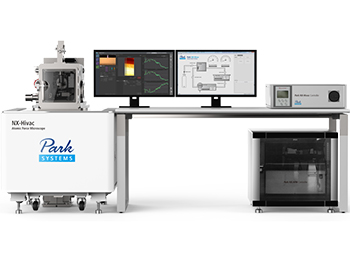

Park為眾多應用提供自動格式的原子力顯微鏡量測,為納米級的樣品提供高級測量和分析。具有粗糙度、高度和深度測量,缺陷檢查,電氣和磁故障分析,熱性能表征和納米力學性能成像等能力。
為半導體生產工藝監控和研究型實驗室提供精確的形貌測量解決方案
對樣品和基片進行高精度表面粗糙度測量
樣品側壁三維結構精確測量。
缺陷檢查成像和分析。
高分辨率電子掃描模式。
低噪聲Z探測器可精確測量AFM表面形貌
業界較領先的低噪聲Z檢測器測量樣品表面形貌
沒有過沿過沖和壓電蠕變誤差的真正樣品表面形貌
即便是高速掃描也可以保持精確的表面高度
行業較領先的前向和后向掃描間隙橫向飄移小于0.15%
用真正的非接觸模式節省成本
在一般用途和缺陷成像中,具有普通掃描模式10倍或更長的針尖使用壽命
減少超細針尖的尖端磨損
真實的再現樣品微觀三維形貌,減少樣品在掃描過程中的損壞或變形
平板掃描器
完整的呈現樣品自身的表面形貌、粗糙度
自動多點樣品掃描、快速掃描
配置主動防震臺、隔音罩
軟件:SmartScan,專用系統控制盒數據采集軟件,AFM數據分析軟件
樣品大小范圍:從2英寸到12英寸的樣品
半導體檢測:GaAs、InP、SiC、GaN、DRAM、MEMS等
生命科學、醫學、電學
材料、化學科學
失效分析
硬盤介質檢測
核聚變研究
量子計算







